高/低温操作寿命 (High/Low Temperature Operation Life Test)是藉由温度、电压的加速因子下,进行新产品验证(NPI)评估和产品可靠性监控(ORM)及产品寿命周期推算。集成电路(IC)产品寿命曲现如下图形成“浴盆(bathtub)”曲线。此曲线可分为三大区段—不良率高的“infant mortality”早期故障率阶段、稳定状态阶段(不良率下降或频率有规律的区段)以及损耗阶段(wear-out)不良率增加的阶段。 早期故障率阶段的不良原因一般出于生产工程上的缺陷,这种缺陷大部分可通过有效的可靠性screen(ELFR)作业来消除。

CHINAISTI 苏试宜特能为您做什么?
高/低温操作寿命 (High/Low Temperature Operation Life Test)时程较长,苏试宜特除建置大产能的实验设备(Chamber)外并因应产品需求提供不同功耗(up to 150W)验证平台,协助您完成相关测试。
对于不同产品属性也有相对应的测试方法及条件,如HTGB(High Temperature Gate Bias) / HTRB(High Temperature Reverse Bias) / BLT(Bias Life Test)等试验手法。
上述各项实验条件,均需要施加电源或信号源,使得组件进入工作状态或稳态,经由电压、温度、时间等加速因子(Acceleration Factor)交互作用下,达到材料老化的效果,并从试验结果计算出预估产品的故障率、MTTF(Mean Time To Failure)及FIT(Failure In Time)。
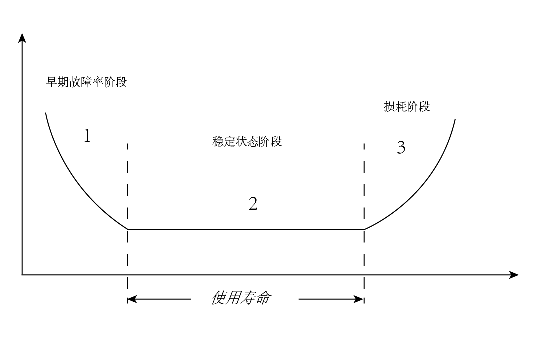
 参考规范
参考规范JESD22-A108
MIT-STD-883E Method 1005.8
JESD47/ JESD74
GJB-548 方法1015.1
GJB-548 方法1016

中国免费咨询电话 : 800-988-0501 Email: marketing_cn@chinaisti.com





