苏试宜特(上海)检测技术股份有限公司(下简称“苏试宜特”)与华东师范大学吴幸教授团队相关静电保护器件物理失效分析研究成果发表于顶级期刊IEEE Transactions on Electron Devices。
2021年,华东师范大学通信与电子工程学院吴幸教授、电子科技大学刘志伟副教授以及苏试宜特,带领“原位先进器件”研究团队,报道了“可视化”的静电保护器件的失效分析。该成果在线发表在本领域顶级期刊IEEE Transactions on Electron Devices (DOI: 10.1109/TED.2021.3053501),该研究工作同时也得到了国家自然科学基金和上海市科委重点项目的资助。

上图摘自:IEEE官方网站
随着摩尔定律进一步缩小,器件尺寸越来越小,结深越来越浅,栅氧化层也越来越薄,先进制程中部分工艺的引入使得静电击穿越来越容易。静电放电(ESD:electrostatic discharge)是造成电子元器件或集成电路系统可靠性降低的重要因素之一。ESD事件的损伤,如人体放电模式(HBM:Human Body Model)、器件充电模式(CDM:Charged Device Model)等。这将严重地恶化半导体芯片的可靠性,从而制约了产品的快速迭代。因此,ESD防护技术已经成为半导体行业不可或缺的研究热点。ESD保护器件的候选者中,可控硅晶闸管(SCR:Silicon-Controlled Rectifier)由于其超高的面积利用率和ESD鲁棒性的优势,在ESD应用领域中脱颖而出。优化此类器件达到更高的应用水平是很重要的。由电子科技大学杜飞波博士提出的增强型横向可控硅器件(EMLSCR:Enhanced Modified Lateral Silicon-Controlled Rectifier)优化了传统的横向可控硅晶闸管,获得了更低的触发电压和更高的鲁棒性,适用于3.3 V的引脚。但是该器件在ESD电应力下的结构演化还不清楚,进一步研究有望提高器件的可靠性。
针对以上问题,吴幸教授团队与苏试宜特公司紧密合作,共同致力于先进器件的可靠性研究工作。利用透射电子显微镜技术(TEM:Transmission Electron Microscope)探索电应力在随机存储器和基于二维材料的新型器件的影响。相关工作发表在相关领域高水平期刊,Nature Communications、Advanced Materials等。实验结果发现,由失效引起的金属细丝的分布方向不均匀,导致EMLSCR器件失效。计算机辅助软件(TCAD:Technology Computer Aided Design)的晶格温度模拟,也发现了失效热点的起源偏向器件的阴极部分。提出将阴极部分加宽,增大电流流通路径,从而提高器件的可靠性。该工作对实际的器件进行物理失效分析,用可靠的实验结果弥补了设计上的不足,为静电保护器件的优化提供了新思路。配图分别为器件结构图与其测试结果,有源区损坏图和接触孔损坏图。
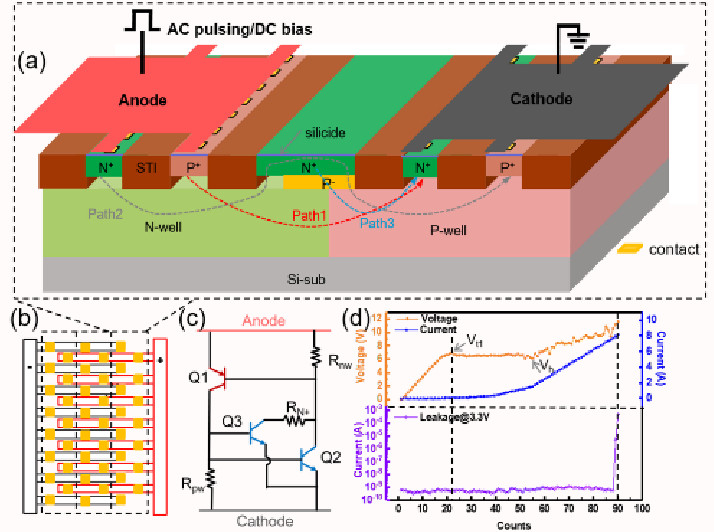
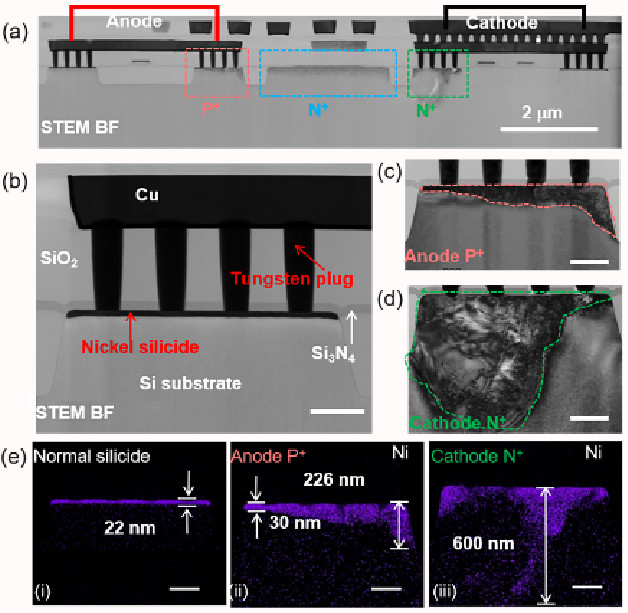
图1 EMLSCR的器件示意图及TLP测试结果 图2 器件失效位置的STEM结果及能谱结果
再次恭喜华东师范大学通信与电子工程学院吴幸教授团队所获得成绩,作为华东师范大学的实习基地,苏试宜特将持续与华东师范大学共同合作,倾力提供专业、精准的技术支持,进行并完成更多的专业研究。
苏试宜特提供芯片线路修改、失效分析、可靠性验证、晶圆微结构与材料分析、车用元器件可靠性验证、板极可靠性等,服务客群覆盖范围包括芯片设计、晶圆制造、封装厂与高端晶圆设备商,提供集成电路全方位一站式分析与验证技术服务。





