苏试宜特TEM工程团队与华东师范大学通信/电子工程学院吴幸教授、电子科技大学刘志伟副教授,利用高分辨率TEM与EDS成分分析针对FinFET 器件材料失效机制探讨。该研究成果已在线发表于2021 IEEE International Symposium on the Physical and Failure Analysis of Integrated Circuits (IPFA) (DOI:10.1109/IPFA53173.2021.9617380),同时,该研究工作也被列入国家自然科学基金和上海市科委重点项目。

在摩尔定律的推动下,半导体器件的特征尺寸不断减小,逐渐逼近平面晶体管的物理极限。鳍式场效应晶体管(Fin Field-Effect Transistor, FinFET)将导电通道立体化,极大增强了栅极控制能力,短沟道效应得到有效抑制,漏电流减小,并且导电通道的轻掺杂使得载流子迁移率显著提高。电性失效是造成电子元器件或集成电路系统可靠性降低的重要因素,FinFET器件作为一种纳米器件,对电应力加载更加敏感,基于FinFET器件的电学可靠性研究具有重要意义。鳍状结构是FinFET器件的重要组成部分,其物理尺寸在纳米量级,传统的研究方法很难做到定点分析,并且在工艺制备过程中易出现工艺问题,需要进行工艺检验以筛选出合格的FinFET器件进行后续研究,避免器件因自身原因造成失效模式混叠,干扰失效分析结果。
针对以上问题,华东师范大学吴幸教授团队与苏试宜特开展合作,共同致力于先进器件的可靠性研究工作,利用透射电子显微镜技术(Transmission Electron Microscopy, TEM)探索电应力对纳米器件、随机存储器以及低维半导体器件的影响,有关工作发表在相关领域高水平期刊、Nature Communications、Advanced Materials等。为针对性研究鳍状结构在不同电应力作用下的失效形式,实验采用的FinFET器件不同于工业界设计,去除多层金属互连结构,电压应力直接加载于器件的栅极接触上,加载的电应力分别为直流电应力(Direct Current, DC)和传输线脉冲电应力(Transmission Line Pulse, TLP)。
研究发现,DC电应力造成的破坏为面积式,器件的栅极接触、隔离绝缘层与鳍状结构均被破坏。同时,鳍状结构底部与硅衬底的交界处被烧熔,出现凹坑,被破坏的隔离绝缘层无法有效抑制元素迁移,导致器件性能更加退化。TLP电应力造成的破坏为区域式,未被破坏的隔离绝缘层部分依旧能够有效抑制元素迁移,鳍状结构被电应力破坏,底部与硅衬底的交界处出现小范围的硅聚集。
研究结果表明,增加栅极接触与鳍状结构的距离、鳍状结构顶部的稳定性、隔离保护层的绝缘性能够有效提高FinFET器件的可靠性。该工作对实际的FinFET器件进行物理失效分析,用可靠的实验结果为FinFET器件的优化提供指导方向。让我们一起来看一下FinFET器件电学特性图与无损器件的整体结构图。
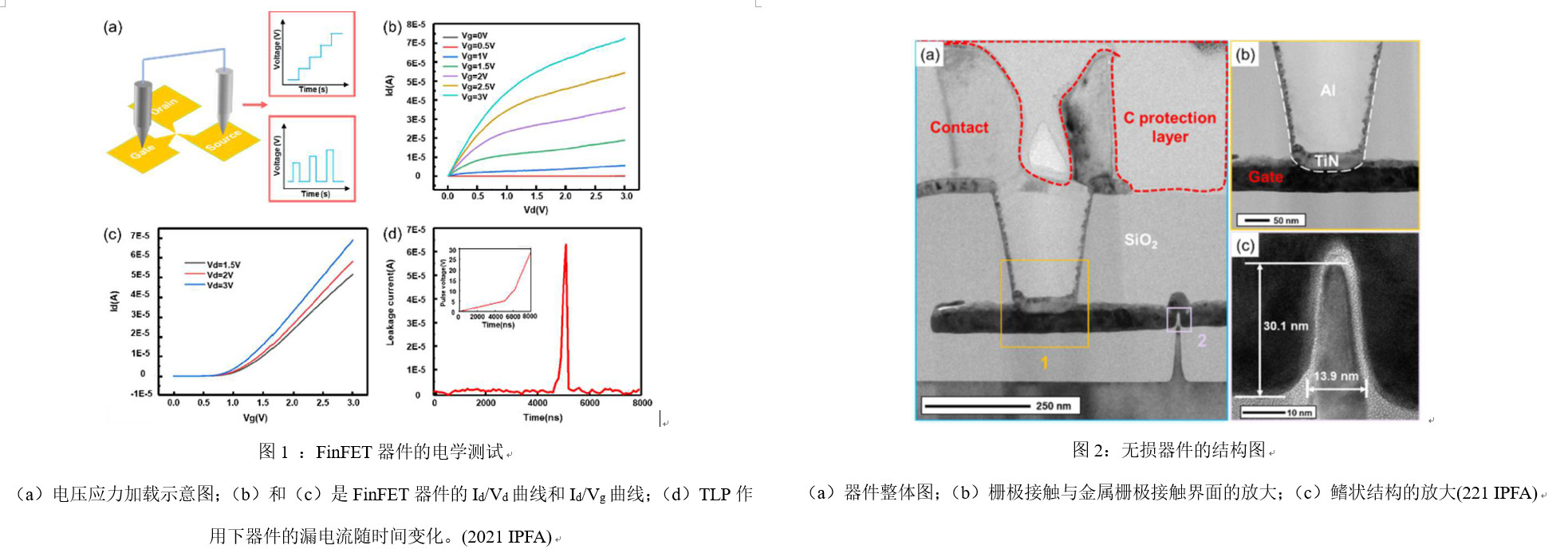
苏试宜特作为华东师范大学通信与电子工程学院的实习基地,将持续深化校企合作,提供专业、精准的分析技术,攻克集成电路产业发展上更多研发课题。
苏试宜特提供芯片线路修改、失效分析、可靠性验证、晶圆微结构与材料分析、车用元器件可靠性验证、板极可靠性等,服务客群覆盖范围包括芯片设计、晶圆制造、封装厂与高端晶圆设备商,提供集成电路全方位一站式分析与验证技术服务。





