Destructive Physical Analysis (DPA)即破坏性物理分析,它是在电子元器件成品批中随机抽取适当样品,采用一系列非破坏和破坏性的物理试验与分析方法,以检验元器件的设计、结构、材料、工艺制造质量是否满足预定用途的规范要求。
 苏试宜特可以为你做什么?
苏试宜特可以为你做什么?
确保产品封装在出货前或是可靠性实验后,成品批中随机抽取适当样品,确认有无结构异常,了解产品可能的缺陷或弱点,就像是产品的健康报告一样,提早的修正问题所在。
 测试条件
测试条件• DPA分析流程
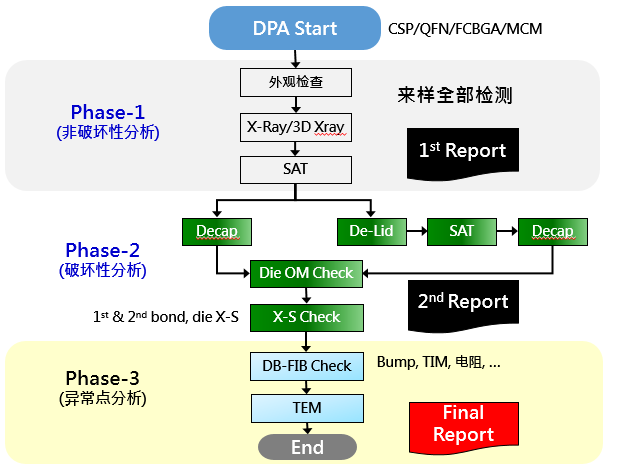
 苏试宜特服务优势
苏试宜特服务优势


 案例分享
案例分享
中国免费咨询电话 : 800-988-0501 Email: marketing_cn@istgroup.com





