IC有问题,想抓出缺陷,却总是选错分析方式与仪器?
近乎隐形的工艺问题,奈米等级的表面污染缺陷,该如何选择到位的分析方式呢?
宜特在验证分析领域二十多年的耕耘中,最常遇到的客户问题就是,「现在面临的失效现象,要用什么工具找到污染缺陷点?!」
污染缺陷点分为两种,有形与无形,这对于IC半导体生产制造都是杀手,皆会导致后续产品的失效或故障。有形的污染大都可藉由光学或电子显微镜放大到数十万倍,即可逮到其踪影;而这近乎隐形无形的污染是从哪儿来的,又该如何去侦查搜寻呢?
本月宜特小学堂,将与各位分享,「如何选择适当表面分析仪器去探究这些有形/无形的污染缺陷」

六大表面污染分析的判断准则,一次奉送给您:
(一) 量测污染物形貌,取得影像后,是否要进一步作成分分析?首选AFM
宜特发现,一般而言,在寻找工艺污染缺陷上,大部分客户习惯直接使用扫描电子显微镜(SEM)量测污染物形貌,取得影像,并且利用SEM加装的X光能量分散光谱仪(EDS)取得后续的成分分析数据。但这个方法用在量测「样品表面的污染缺陷」是对的吗?
答案是,有比SEM+EDS更好的选择工具!
原因在于,透过SEM进行表面分析,为了便于样品导电,样品需要镀金,才能照出清楚的表面污染物形貌(影像),然而镀金后的样品,却不利于后续做表面污染成分分析,只能测到表面镀金的讯号,无法获得真正表面污染物的成分。
因此,建议选择原子力显微镜(AFM),其原理是靠原子之间的交互作用力(非电子),不仅可直接扫描污染物表面讯号,取得清楚的3D立体形貌影像;而后续要用其他工具分析污染物的成分组成,因样品不需镀金导电,也不致受到干扰。
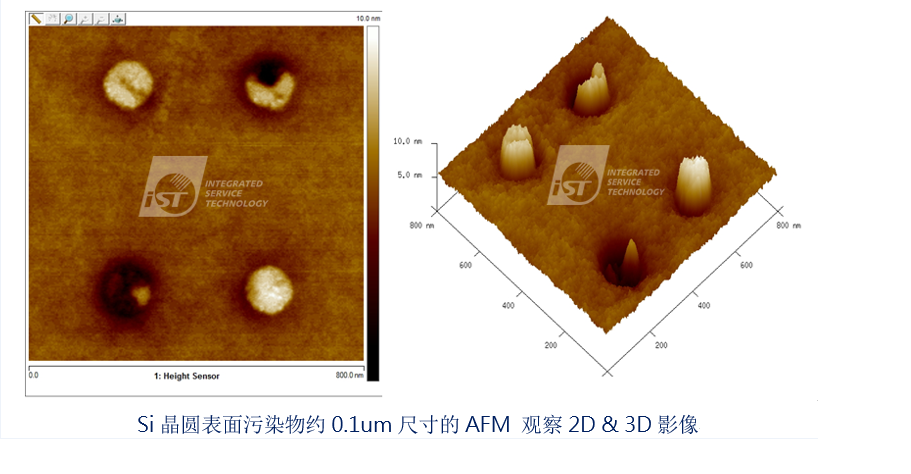
(二) 欲进行污染物成分分析,需先判断污染物尺寸
一般而言,在寻找工艺污染缺陷上,宜特发现,大部分客户亦习惯直接使用SEM的EDS做快速的成分分析,然而EDS侦测讯号是来自样品较「底部」的X光反射,较无法测到样品「表面」污染讯号。因此不建议用EDS进行表面为污染分析。
大于10um污染物,选择XPS/ ESCA
建议使用X光电子能谱仪(XPS/ESCA)的仪器进行成分与半定量分析
小于10um时,选择AES
选择俄歇电子能谱仪(AES)来进行
上述两种仪器的浓度侦测极限约0.1 at. %。周期表内原子序3(Li)以上的元素均可分析。

(三) 是否需要了解污染物的化学键结态,首选XPS/ ESCA
若希望探究污染物的”化学键结”(Chemical State/Bonding),就可经由XPS/ ESCA,进一步针对定性的化学元素做细部解析,分析其成分的键结型态,以判断化学性质的差异。不过首要条件限制为污染物的尺寸大小需超过10um。
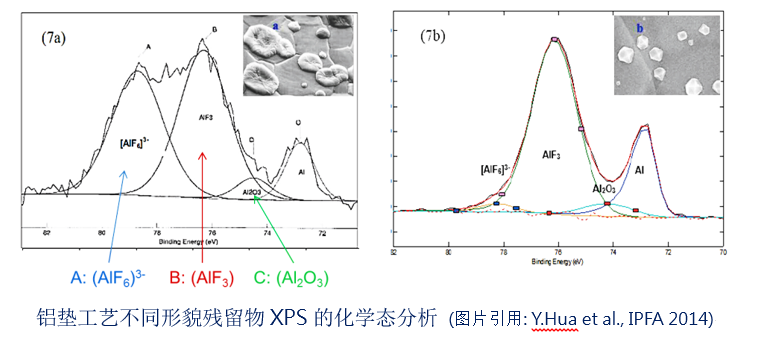
(四) 是否需要进行「有机物污染鉴定」
厚度1um 以上,尺寸大于30um
选择FTIR当定性分析发现化学元素主要为C, O, N这类的元素时,可进一步选用傅立叶红外光谱仪 (FTIR),进行「有机物」(Organic)的分析。搭配宜特内建庞大的光谱数据库,可进行厚度1um以上,尺寸大于30um以上的异物分析。
厚度1um 以上,尺寸小于30um
选择Raman如果是尺寸小于30um而厚度大于1um尺寸的异物,可选用拉曼光谱仪(Raman)来鉴定。拉曼光谱的数据库可配合客户,将其生产工艺上所用的物质全部建立后,再进行异物的分析鉴定。
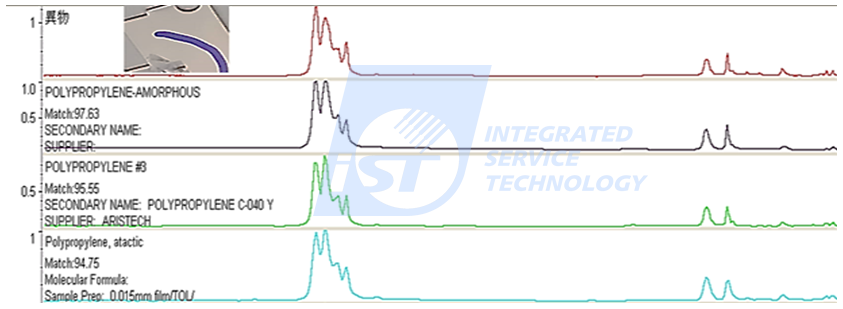
金属支架上有机污染物的FTIR分析鉴定比对为PP聚丙烯
(五) 针对不同大小的无形超薄污染物
宽度10um 以上,选择XPS/ ESCA
如果异物是无形的,且是数十奈米厚的污染物,样品待测区域宽度大于10um选用XPS/ ESCA
宽度10um 以下,选择AES
样品待测区域宽度小于10um选用AES来进行。
若确认为有机污染时,选择SIMS
有机污染必须选用静态式二次离子质谱仪 (Static SIMS)来进行。最常应用即为飞行时间差二次离子质谱仪(TOF-SIMS)。周期表内原子序1(H)以上元素均可分析。待测区域需 大于100um。
(六) 是否做定量分析,选择SIMS
定量分析一般用已知浓度的标准样品,来进行未知污染样品浓度含量之计算。动态式二次离子质谱仪(Dynamic SIMS)是利用离子高产率与极低的侦测极限特性,是Si或InP、GaAs这类材料内微量污染元素的最佳定量分析仪器。其浓度侦测极限约ppma~ppba。待测样品区域需大于 100um,厚度需要大于100nm以上才适合SIMS定量的分析。
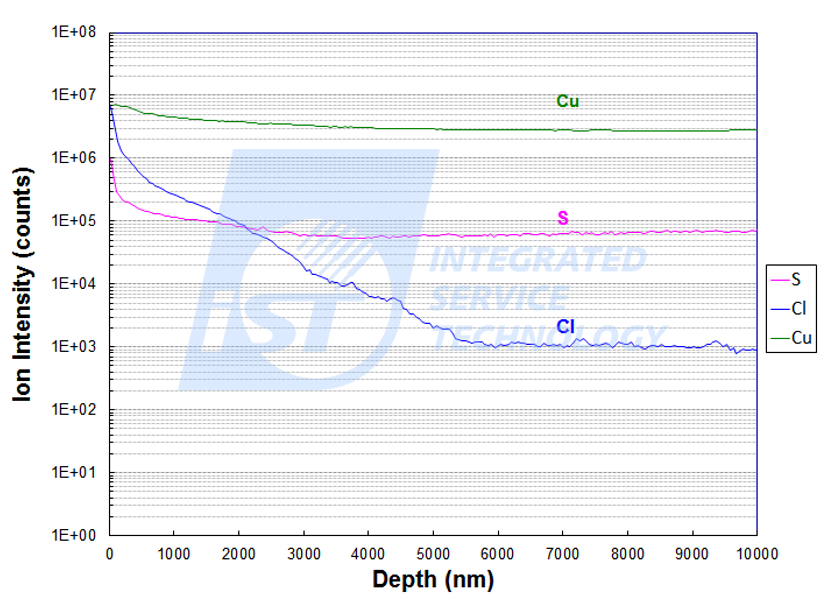
苏试宜特提供芯片线路修改、失效分析、可靠性验证、晶圆微结构与材料分析、车用元器件可靠性验证、板极可靠性等,服务客群覆盖范围包括芯片设计、晶圆制造、封装厂与高端晶圆设备商,提供集成电路全方位一站式分析与验证技术服务。





