聚焦式离子束显微镜(Focus Ion Beam),简称FIB)电路修改,原理是利用镓离子撞击样品表面,搭配有机气体进行有效的选择性蚀刻(切断电路)、沉积导体或非导体(新接电路)。

CHINAISTI 苏试宜特能为您做什么?
电路修改(FIB circuit)
通过聚焦式离子束显微镜(Focus Ion Beam),即可提供芯片设计者直接修改芯片电路,无需重复改光罩重新投片,不仅可降低经费,更可加速芯片设计原型(Prototype)的验证与量产上市时间(Time-to-market)。
点针垫侦错 (CAD Probe Pad)
在芯片上做信号撷取点,通过FIB将芯片设计者欲量测的信号点引出到芯片表面,并利用机械式探针(Mechanical Prober) 撷取芯片内部信号。
晶背电路修改
随着覆晶封装基材限制,与先进制程演持续进到7nm,金属绕线层增加以及更为复杂紧密的电路布局,从晶背(Silicon)进行電路修改提升可行性与成功率。
 苏试宜特服务优势
苏试宜特服务优势


设备能量
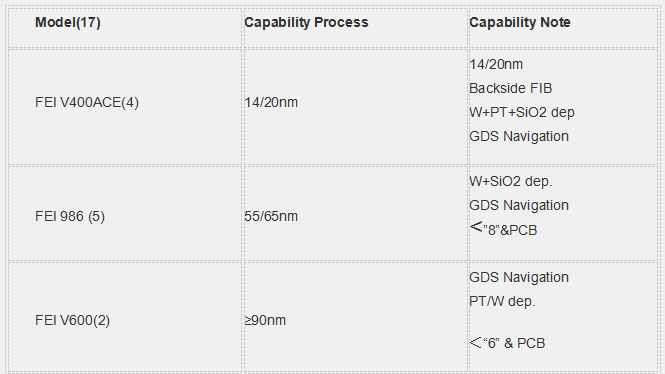
提升电路修改良率建议
去封胶、打线或封装后,先回测再进行FIB
同一颗芯片上执行越多的修改内容,Fail风险会越高。
FIB联机的阻值较原芯片联机要高,若有低电阻联机過高電流需求,请于委案时先注明。
提供GDS II以利定位(局部区域或层数即可)作业,有助良率提升。

中国免费咨询电话 : 800-988-0501 Email: marketing_cn@chinaisti.com





