扫描式电子显微镜,又扫描电镜(Scanning Electron Microscope, SEM)主要是利用微小聚焦的电子束(Electron Beam)进行样品表面扫描。 此电子束(Electron Beam)与样品间的交互作用会激发出各种信号,如: 二次电子、背向散射电子及特性X光等,SEM主要就是收集二次电子的信号来成像。

CHINAiSTI 苏试宜特能为您做什么?
SEM景深大、分辨率高,放大倍率可达到数十万倍以上,可用来观察样品表面及剖面微结构。如在设备上加装能量分散X光谱仪(Energy Dispersive Spectrometer, 简称EDS)时,可对样品表面同时进行微区之材料分析,包括定性、半定量之成分分析以及特定区域之Point、Line Scan、Mapping分析。
 苏试宜特服务优势
苏试宜特服务优势苏试宜特拥有多台目前业界主流的场发射扫描式电子显微镜(扫描电镜,FE-SEM):FEI Nova Nano 450、Hitachi su8010、Hitachi SU8220,且加装EDS (SDD detector),可提供高解析之表面结构分析影像,亦可快速进行材料成份之分析。
 案例分享
案例分享

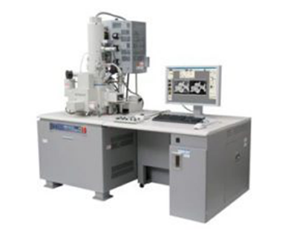

中国免费咨询电话 : 800-988-0501 Email: marketing_cn@chinaisti.com





